球形触点陈设,外表贴装型封装之一。在印刷基板的反面按陈设办法制造出球形凸点用以替代引脚,在印刷基板的正面装置LSI芯片,然后用模压树脂或灌封办法进行密封。也称为凸点陈设载体(PAC)。引脚可超越200,是多引脚LSI用的一种封装。封装本体也可做得比QFP(四侧引脚扁平封装)小。例如,引脚中心距为1.5mm的360引脚BGA仅为31mm见方;而引脚中心距为0.5mm的304引脚QFP为40mm见方。
并且BGA不必忧虑QFP那样的引脚变形问题。该封装是美国Motorola公司开发的,首先在便携式电话等设备中被选用,往后在美国有可能在个人计算机中遍及。开端,BGA的引脚(凸点)中心距为1.5mm,引脚数为225。现在也有一些LSI厂家正在开发500引脚的BGA。BGA的问题是回流焊后的外观查看。现在尚不清楚是否有用的外观查看办法。有的以为,因为焊接的中心距较大,衔接可以看作是安稳的,只能经过功用查看来处理。美国Motorola公司把用模压树脂密封的封装称为OMPAC,而把灌封办法密封的封装称为GPAC(见OMPAC和GPAC)。

带缓冲垫的四侧引脚扁平封装。QFP封装之一,在封装本体的四个角设置突起(缓冲垫)以避免在运送过程中引脚产生曲折变形。美国半导体厂家主要在微处理器和ASIC等电路中选用此封装。引脚中心距0.635mm,引脚数从84到196左右(见QFP)。


用玻璃密封的陶瓷双列直插式封装,用于ECLRAM,DSP(数字信号处理器)等电路。带有玻璃窗口的Cerdip用于紫外线擦除型EPROM以及内部带有EPROM的微机电路等。引脚中心距2.54mm,引脚数从8到42。在日本,此封装表明为DIP-G(G即玻璃密封的意思)。

外表贴装型封装之一,即用下密封的陶瓷QFP,用于封装DSP等的逻辑LSI电路。带有窗口的Cerquad用于封装EPROM电路。散热性比塑料QFP好,在天然空冷条件下可容许1.5~2W的功率。但封装本钱比塑料QFP高3~5倍。引脚中心距有1.27mm、0.8mm、0.65mm、0.5mm、0.4mm等多种规范。引脚数从32到368。
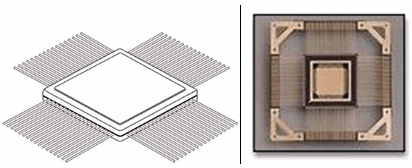
带引脚的陶瓷芯片载体,外表贴装型封装之一,引脚从封装的四个旁边面引出,呈丁字形。带有窗口的用于封装紫外线擦除型EPROM以及带有EPROM的微机电路等。此封装也称为QFJ、QFJ-G(见QFJ)。
带引脚的陶瓷芯片载体,外表贴装型封装之一,引脚从封装的四个旁边面引出,呈丁字形。带有窗口的用于封装紫外线擦除型EPROM以及带有EPROM的微机电路等。此封装也称为QFJ、QFJ-G(见QFJ)。

板上芯片封装,是裸芯片贴装技能之一,半导体芯片交代贴装在印刷线路板上,芯片与基板的电气衔接用引线缝合办法完成,芯片与基板的电气衔接用引线缝合办法完成,并用树脂掩盖以保证可*性。尽管COB是最简略的裸芯片贴装技能,但它的封装密度远不如TAB和倒片焊技能。
插装型封装之一,引脚从封装两边引出,封装资料有塑料和陶瓷两种。DIP是最遍及的插装型封装,运用规模包含规范逻辑IC,存贮器LSI,微机电路等。
引脚中心距2.54mm,引脚数从6到64。封装宽度一般为15.2mm。有的把宽度为7.52mm和10.16mm的封装别离称为skinnyDIP和slimDIP(窄体型DIP)。但大都情况下并不加区分,只简略地统称为DIP。别的,用低熔点玻璃密封的陶瓷DIP也称为cerdip(见cerdip)。


双侧引脚带载封装。TCP(带载封装)之一。引脚制造在绝缘带上并从封装两边引出。因为运用的是TAB(主动带载焊接)技能,封装外形十分薄。常用于液晶显示驱动LSI,但大都为定制品。别的,0.5mm厚的存储器LSI簿形封装正处于开发阶段。在日本,依照EIAJ(日本电子机械工业)会规范规则,将DICP命名为DTP。


扁平封装。外表贴装型封装之一。QFP或SOP(见QFP和SOP)的别称。部分半导体厂家选用此称号。

倒焊芯片。裸芯片封装技能之一,在LSI芯片的电极区制造好金属凸点,然后把金属凸点与印刷基板上的电极区进行压焊衔接。封装的占有面积基本上与芯片尺度相同。是一切封装技能中体积最小、最薄的一种。
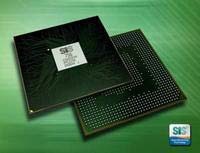
小引脚中心距QFP。一般指引脚中心距小于0.65mm的QFP(见QFP)。部分导导体厂家选用此称号。塑料四边引出扁平封装PQFP(PlasticQuadFlatPackage)PQFP的封装方式最为遍及。其芯片引脚之间间隔很小,引脚很细,许多大规模或超大集成电路都选用这种封装方式,引脚数量一般都在100个以上。Intel系列CPU中80286、80386和某些486主板芯片选用这种封装方式。此种封装方式的芯片有必要选用SMT技能(外表装置设备)将芯片与电路板焊接起来。选用SMT技能装置的芯片不必在电路板上打孔,一般在电路板外表上有设计好的相应引脚的焊点。将芯片各脚对准相应的焊点,即可完成与主板的焊接。用这种办法焊上去的芯片,假如不必专用工具是很难拆开下来的。SMT技能也被广泛的运用在芯片焊接范畴,尔后许多高档的封装技能都需求运用SMT焊接。
以下是一颗AMD的QFP封装的286处理器芯片。0.5mm焊区中心距,208根I/O引脚,外形尺度28?28mm,芯片尺度10?10mm,则芯片面积/封装面积=10?10/28?28=1:7.8,由此可见QFP比DIP的封装尺度大大减小了。


右邊這顆晶片為一種軍用晶片封裝(CQFP),這是封裝還沒被放入晶體曾经的樣子。這種封裝在軍用品以及航太工業用晶片才有機會見到。晶片槽旁邊有厚厚的黃金隔層(有高起來,相片上不明顯)用來避免輻射及其他干擾。外圍有螺絲孔可以將晶片牢牢固定在主機板上。而最风趣的便是四周的鍍金針腳,這種設計可以大大減少晶片封裝的厚度並供给極佳的散熱。
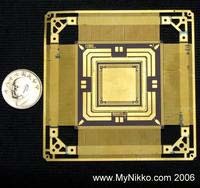

外表贴装型PGA。一般PGA为插装型封装,引脚长约3.4mm。外表贴装型PGA在封装的底面有陈设状的引脚,其长度从1.5mm到2.0mm。贴装选用与印刷基板碰焊的办法,因此也称为碰焊PGA。因为引脚中心距只要1.27mm,比插装型PGA小一半,所以封装本体可制造得不怎样大,而引脚数比插装型多(250~528),是大规模逻辑LSI用的封装。封装的基材有多层陶瓷基板和玻璃环氧树脂印刷基数。以多层陶瓷基材制造封装现已有用化。
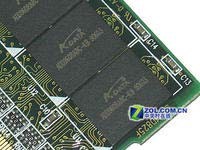
J形引脚芯片载体。指带窗口CLCC和带窗口的陶瓷QFJ的别称(见CLCC和QFJ)。部分半导体厂家选用的称号。
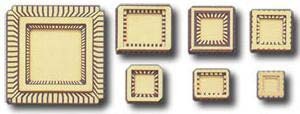
无引脚芯片载体。指陶瓷基板的四个旁边面只要电极触摸而无引脚的外表贴装型封装。是高速和高频IC用封装,也称为陶瓷QFN或QFN-C(见QFN)。

触点陈设封装。即在底面制造有阵列状况坦电极触点的封装。装置时刺进插座即可。现已有用的有227触点(1.27mm中心距)和447触点(2.54mm中心距)的陶瓷LGA,运用于高速逻辑LSI电路。
LGA与QFP比较,可以以比较小的封装包容更多的输入输出引脚。别的,因为引线的阻抗小,关于高速LSI是很适用的。但因为插座制造杂乱,本钱高,现在基本上不怎样运用。估计往后对其需求会有所增加。

芯片上引线封装。LSI封装技能之一,引线结构的前端处于芯片上方的一种结构,芯片的中心邻近制造有凸焊点,用引线缝合进行电气衔接。与本来把引线结构安置在芯片旁边面邻近的结构比较,在相同巨细的封装中包容的芯片达1mm左右宽度。
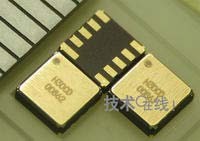
薄型QFP。指封装本体厚度为1.4mm的QFP,是日本电子机械工业会依据拟定的新QFP外形规范所用的称号。

陶瓷QFP之一。封装基板用氮化铝,基导热率比氧化铝高7~8倍,具有较好的散热性。封装的结构用氧化铝,芯片用灌封法密封,然后按捺了本钱。是为逻辑LSI开发的一种封装,在天然空冷条件下可容许W3的功率。现已开发出了208引脚(0.5mm中心距)和160引脚(0.65mm中心距)的LSI逻辑用封装,并于1993年10月开端投入批量出产。

MCM-C是用厚膜技能构成多层布线,以陶瓷(氧化铝或玻璃陶瓷)作为基板的组件,与运用多层陶瓷基板的厚膜混合IC类似。两者无显着不同。布线密度高于MCM-L。
MCM-D是用薄膜技能构成多层布线,以陶瓷(氧化铝或氮化铝)或Si、Al作为基板的组件。布线密议在三种组件中是最高的,但本钱也高。


依照JEDEC(美国联合电子设备委员会)规范对QFP进行的一种分类。指引脚中心距为0.65mm、本体厚度为3.8mm~2.0mm的规范QFP(见QFP)。

美国Olin公司开发的一种QFP封装。基板与封盖均选用铝材,用粘合剂密封。在天然空冷条件下可容许2.5W~2.8W的功率。日本新光电气工业公司于1993年取得特许开端出产。
模压树脂密封凸点陈设载体。美国Motorola公司对模压树脂密封BGA选用的称号(见BGA)。
印刷电路板无引线封装。日本富士通公司对塑料QFN(塑料LCC)选用的称号(见QFN)。引脚中心距有0.55mm和0.4mm两种规范。现在正处于开发阶段。


陈设引脚封装。插装型封装之一,其底面的笔直引脚呈陈设状摆放。封装基材基本上都选用多层陶瓷基板。在未专门表明出资料称号的情况下,大都为陶瓷PGA,用于高速大规模逻辑LSI电路。本钱较高。引脚中心距一般为2.54mm,引脚数从64到447左右。了为降低本钱,封装基材可用玻璃环氧树脂印刷基板替代。也有64~256引脚的塑料PGA。别的,还有一种引脚中心距为1.27mm的短引脚外表贴装型PGA(碰焊PGA)。(见外表贴装型PGA)。
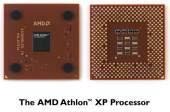
驮载封装。指配有插座的陶瓷封装,形关与DIP、QFP、QFN类似。在开发带有微机的设备时用于点评程序承认操作。例如,将EPROM刺进插座进行调试。这种封装基本上都是定制品,市场上不怎样流转。